
26Monisirumoduulit olivat muutama vuosikymmenen sitten helpoin tapa pakata enemmän suoritinvoimaa yhteen pakettiin. Nyt tekniikkaa ollaan otamassa uudelleen käyttöön, mutta nyt kokonaan piihin paketoituna. Intelin, AMD:n, Applen ja ARM:n lisäksi aihe kiinnostaa myös Qualcommia sekä siruvalmistajista TSMC:tä ja Samsungia.
Ensimmäiset monisirumoduulit ilmestyivät jo 80-luvun alusta IBM:n toimesta suurtietokoneissa, mutta 1990-luvun puolivälissä myös Intel otti tekniikan käyttöön tehokkaimmassa Pentium Pro-suorittimissa. Perinteistä piiritekniikkaa kalliimpana tekniikka kuitenkin jäi hiljalleen pois muodista, kunnes aivan viime vuosina opittiin tekemään yhä isompikokoisia ja tiheämpiä yksittäisiä siruja edullisesti ne ovat tulleet takaisi.
Uudet chipletit
Erityisesti Intel ja AMD ovat ryhtyneet käyttämään Multi-Chip-moduulipakkaamista (MCM) uusimmissa PC-prosessoreissa ja mobiililaitteiden järjestelmäpiireissä. Nykyisin niin sanotussa chiplet-ratkaisuissa yhden suuren monoliittisen piirin valmistamisen sijasta mikropiiri jaetaankin useampaan pieneen osioon, jotka tuodaan yhteen uudenlaisin kotelointiratkaisuin. Suoritinvalmistajista AMD oli ensimmäisten joukossa ottamassa käyttöön chiplet-ratkaisua Ryzen-suorittimissaan. Myös Intelin tuleva Sapphire Rapids Xeon-prosessori käyttänee vastaavaa ratkaisua. Apple rakensi M1 Ultra -piirinsä kahdesta erillisestä sirusta.
Lähestymistapa sijoittaa useita piisiruja saamaan koteloon yhden sijasta tarjoaa muun muassa paremman piirien saannon, mahdollisuuden yhdistellä eri valmistusprosesseilla tehtyjä osia sekä lohkojen uudelleenkäytön. Haittana on tietenkin suurempi virrankulutus ja korkeammat piirin sisäiset vasteajat.
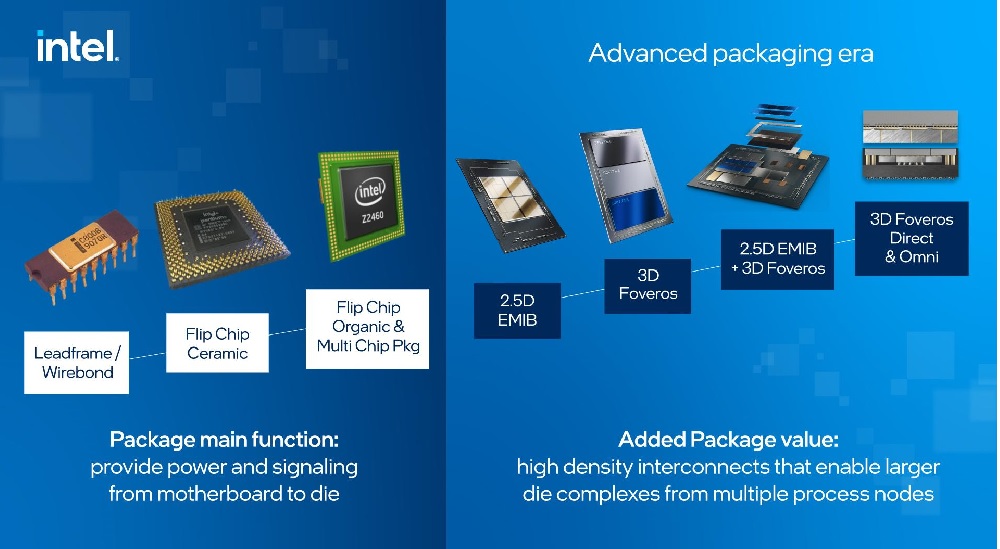
Avoin standardi käyttöön
Monisirunen Chiplet kuitenkin kiinnostaa suoritinvalmistajien lisäksi myös muitakin alan toimijoita. Intelin, AMD:n, ARM:n ja Qualcommin lisäksi isot piirivalmistajat TSMC ja Samsung ovat jo standardoimassa chiplet-ratkaisujaan.
Uuden avoimen Universal Chiplet Interconnect Express (UCIe) -spesifikaation avulla eri valmistajien prosessiteknologioilla suunnittelemat ja valmistamat sirut saataisiin toimimaan yhdessä. Niitä voitaisiin yhdistellä vierekkäin sijoittamisen lisäksi myös päällekkäin. Nykyisin flash-muistisiruja on jo pinottu päällekkäin. Ratkaisu voi ollakin houkutteleva vaihtoehto sovelluksissa, kuten kännyköissä tai muistikorteissa. Muisti voidaan pinota myös suoraan suoritinpiirin päälle.
Intel aikoo pakata yhteen biljoona transistoria
Viime vuosina piiriprosessien kanssa kompuroinut Intel esitteli vasta Hot Chips 34 -tapahtumassa uudenlaisia ajatuksia monisiruratkaisuistaan. Jos aiemmin piirien pakkaustiheys tuli uusista tiukemmista siruprosesseista nyt osa tulee uudenlaisista pakkausinnovaatioista.
Intelin toimitusjohtaja Pat Gelsinger korosti tapahtumassa juuri arkkitehtuurien lisäksi uusia pakkausinnovaatioita, jotka mahdollistavat 2,5 D- ja 3D-pohjaiset ratkaisut. ’’Yhdessä muiden edistysratkaisujen, kuten RibbonFETin, PowerVian, High NA -litografian ja 2,5D- ja 3D-pakkausten avulla tavoitteenamme on siirtyä piiriratkaisuissa vuoteen 2030 mennessä sadasta miljardista transistorista biljoonaan’’, Intelin Pat Gelsinger ennusti. Myös Intelin Meteor Lake-, Arrow Lake- ja Lunar Lake -prosessorit saavat uutta potkua monisiruratkaiuista. Tämä tehdään Intelin mukaan erillisillä CPU-, GPU-, SoC- ja I/O-siruilla, jotka on pinottu 3D-ratkaisuksi Intelin Foveros-yhdyskytkentätekniikan avulla.
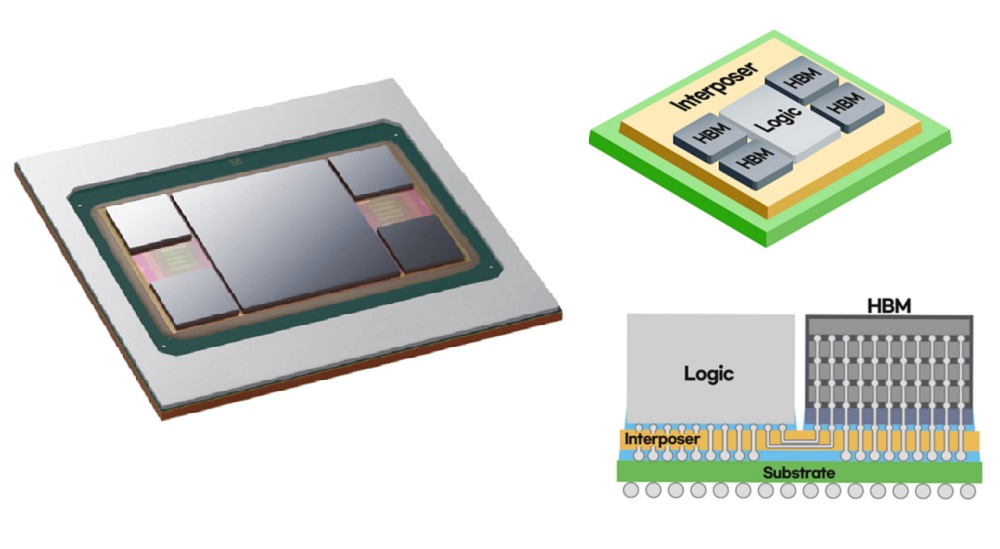
Lisäksi Intelin suurteholaskentaa varten on tulossa Intel Data Centerin GPU, koodinimeltään Ponte Vecchio. Se yhdistäisi 47 piipalasta yhteen pakkaukseen. Ne yhdistetään moduulissa sulautetun monisäteisen liitäntäsillan (EMIB) ja Foveros-tekniikoiden avulla. Nopea MDFI-liitäntä mahdollistaa paketin skaalaamisen jopa kahteen pinoon, jolloin yksi paketti voi sisältää jopa yli 100 miljardia transistoria.
Tulevat Foveros-kehitysratkaisut, Foveros Omni ja Foveros Direct, tulevat tarjoamaan lisää skaalausta ja uutta yhteenliittämistä. Foveros Omni vie liitäntävälin 25 mikroniin, mikä tarjoaa jo noin 4-kertaisen tiheyden EMIB:hen verrattuna. Tulevaisuudessa Foveros Direct toisi juottamattoman suoran kupari-kuparisidoksen, mikä mahdollistaa matalaresistanssiset liitännät ja alle kymmenen mikronin liitäntävälit.
Samsungin vastaus monisirupakkauksiin
Korealainen Samsung hyödyntää kaupallisten piirien lisäksi myös omaa sirutuotatoaan. Se on kehittänyt I-Cube-nimeä kantavan ratkaisun, jossa voidaan sijoittaa vaakasuoraan yksi tai useampia suoritinpiirejä ja useita laajan kaistan HBM-muistiratkaisuja piiripiinan päälle.
Yritys julkisti I-Cube2-ratkaisun vuonna 2018 ja sen eXtended-Cube (X-Cube) vuonna 2020. Vuosi sitten esittelemä 2.5D-integraatioratkaisussa I-Cube4 oli neljä HBM-liitäntää ja yksi logiikkasiru. Tulossa on myös I-Cube6, jossa hyödynnetään vielä kehittyneempiä 2.5/3D-pakkaustekniikoita.
Lisää: Intelin Mooren laki (LINKKI), Chiplet-ekosysteemi (LINKKI), Samsung I-Cube4 (LINKKI) ja UCIe 1.0 -monisirustandardi (LINKKI) ja Uusiteknologia.fi:n artikkeli Applen (LINKKI) ja tehopiirien ratkaisuista (LINKKI).
Kuvat: Valmistajat
